ボンディングは、半導体素子の結合や組み立に不可欠な接合技術です。半導体素子のことをダイといいますが、これをパッケージなどの基板に固定することをダイボンディングといっています。一方、半導体チップのパッドと外部接続パッド間を金線や銀線を溶接して接合することをワイアボンディングといっています。はんだ付け性と同様に濡れ性の制御がキーポイントです。
| めっき種類 | 特性値 | 用途 |
|---|---|---|
| 金合金めっき | 半導体素子の電極部とパッケージ側の接続部(リード)を熱圧着または超音波圧着する際には、表面酸化のない金合金めっきが施されています。 | ・電子部品 ・半導体部品 |
| 無電解ニッケル | 半導体関係で、溶接やろう付けが要求される箇所には無電解ニッケルめっきが行われています。 |
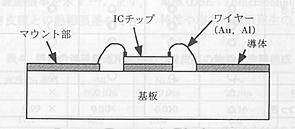
半導体素子の電極部とパッケージリードとのワイヤボンディング
(表面処理工学・表面処理技術協会編・日刊工業新聞社より)

めっきの種類